AMEC 3DNAND Patent

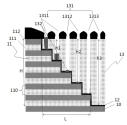
Summary of the invention
The purpose of the present invention is to expand the process window of a semiconductor structure for forming holes or grooves of different depths and different aspect ratios. By adjusting the bias RF power and the type and flow rate of the etching gas, the margin of the cut-off layer in holes of different depths and different aspect ratios can be regulated, so that the margin of the cut-off layer in a deep hole with a large aspect ratio can be slightly smaller than or equal to the margin of the cut-off layer in a hole of medium depth and a small aspect ratio.
In order to achieve the above object, the present invention provides a method for processing a semiconductor structure, comprising the following steps:
A substrate is provided, the substrate comprising a base layer arranged on a substrate, the base layer having a slope structure formed by gradually extending the side from the top surface toward the substrate, the slope structure is covered with a cut-off layer, and a dielectric layer is arranged on the cut-off layer;
Turning on the source radio frequency and the bias radio frequency, introducing the first etching gas, etching the dielectric layer to form a plurality of first-type holes, second-type holes and third-type holes with different aspect ratios, until the third-type holes expose the cutoff layer; wherein the aspect ratio of the third-type holes is greater than the aspect ratio of the second-type holes and greater than the aspect ratio of the first-type holes ;
Reducing the power of the bias radio frequency so that the openings of the first type of holes, the second type of holes, and the third type of holes are lateral-etched for a preset time;
A second etching gas is introduced to etch the cutoff layer exposed by the third type of holes. During the etching process, the flow rate of the second etching gas increases linearly with the etching time at a slope k until the cutoff layer of the third type of holes is etched to a preset depth.
Compared with the prior art, the technical solution of the present invention has at least the following technical effects:
The present invention reduces the power of bias radio frequency until the third type of hole exposes the cutoff layer, so that the bottom characteristic dimension (BCD) of the bottom of the third type of hole can be opened, which is convenient for etching the cutoff layer in the third type of hole, and can increase the carbon-containing deposition layer of the second type of hole, thereby delaying the etching of the cutoff layer in the second type of hole.
Furthermore, the present invention also introduces a second etching gas that is beneficial to etching deep holes. The flow rate of the second etching gas increases linearly, so that the cutoff layer in the third type of hole can be etched to a set depth, while only the carbon-containing deposition layer is consumed in the second type of hole. The cutoff layer in the second type of hole is almost not etched, thereby achieving control of the remaining amount of the cutoff layer in through holes or grooves of different depths and different aspect ratios, and expanding the process window for penetrating the cutoff layer process.